共用装置
分野から探す
リソグラフィ
レジスト処理装置
スピンコーター Spin coater
- 機器ID
- ARIM装置番号:HK-707
- メーカー名(英語表記)
- ミカサ(MIKASA)
- 型番
- MS-A150
- 装置の特長及び仕様
試料サイズ:最大4インチ
回転数:0-4000rpm
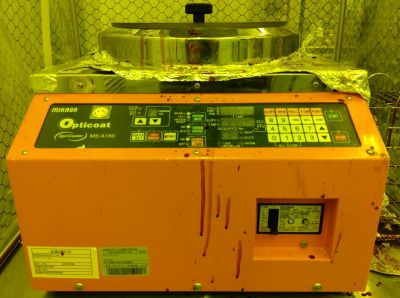
電子線描画(EB)
電子線/レーザー描画露光現像シミュレータ(ソフトウェア) Exposure and development simulation software (compatible with EB and laser drawing)
- 機器ID
- ARIM登録番号:HK-XXX GFC装置番号:AP-200096
- メーカー名(英語表記)
- GenISys㈱
- 型番
- BEAMER Pro
- 装置の特長及び仕様
電子線描画時に生じる近接効果を補正して設計通りのパターンを電子線で描画するためのパターン補正システム。グレースケール露光用のデータ生成が可能。
● BEAMER Pro Package BLT01
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/instruments/2655

電子ビーム描画装置(30kV) Electron-beam lithography system(30kV)
- 機器ID
- ARIM装置番号:HK-701 GFC装置番号:AP-200018
- メーカー名(英語表記)
- エリオニクス(ELIONIX)
- 型番
- ELS-3700
- 装置の特長及び仕様
電子銃エミッター:LaB6
加速電圧:1~30kV
最小線幅:100nm
試料サイズ:最大4インチ
円弧スキャン可データご提供用のエクセルファイルはこちらHK-701_Electron-beam_lithography_system(30kV)_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1388

超高精度電子ビーム描画装置(100kV) Ultra-high precision electron-beam lithography system(100kV)
- 機器ID
- ARIM装置番号:HK-601 GFC装置番号:AP-200002
- メーカー名(英語表記)
- エリオニクス(ELIONIX)
- 型番
- ELS-7000HM
- 装置の特長及び仕様
加速電圧:100kV
試料サイズ:最大6インチデータご提供用のエクセルファイルはこちらHK-601_Ultra-high_precision_electron-beam_lithography_system(100kV)_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1373
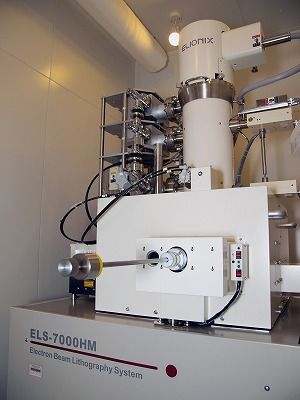
超高精度電子ビーム描画装置(125kV) Ultra-high precision electron-beam lithography system(125kV)
- 機器ID
- ARIM装置番号:HK-602 GFC装置番号:AP-200001
- メーカー名(英語表記)
- エリオニクス(ELIONIX)
- 型番
- ELS-F125
- 装置の特長及び仕様
加速電圧:125kV
試料サイズ:最大6インチデータご提供用のエクセルファイルはこちらHK-602_Ultra-high_precision_electron-beam_lithography_system(125kV)_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1372
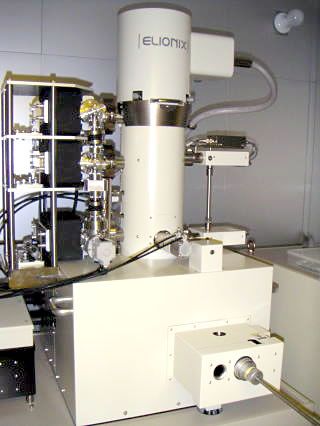
超高速スキャン電子線描画装置(130kV) High-speed scanning electron-beam lithography system(130kV)
- 機器ID
- ARIM装置番号:HK-603 GFC装置番号:AP-200059
- メーカー名(英語表記)
- エリオニクス(ELIONIX)
- 型番
- ELS-F130HM
- 装置の特長及び仕様
加速電圧:130kV
試料サイズ:最大8インチデータご提供用のエクセルファイルはこちらHK-603_High-speed_scanning_electron-beam_lithography_system(130kV)_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1416

光露光(マスクレス、直接描画)
レーザー描画装置 Laser lithography system
- 機器ID
- ARIM装置番号:HK-604 GFC装置番号:AP-200080
- メーカー名(英語表記)
- ハイデルベルグ(Heidelberg)
- 型番
- DWL66+
- 装置の特長及び仕様
光源:405nm半導体レーザー
描画エリア:最大8インチ角
最小描画線幅:0.3ミクロン(HiRes)、0.8ミクロン(WMII)
255階調グレースケールモード搭載
バックアライメント機能データご提供用のエクセルファイルはこちらHK-604_Laser_lithography_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1520

レーザー直接描画装置 Laser direct lithography system
- 機器ID
- ARIM装置番号:HK-605 GFC装置番号:AP-200004
- メーカー名(英語表記)
- ネオアーク(NEOARK)
- 型番
- DDB-201
- 装置の特長及び仕様
光源:375nm半導体レーザー
描画エリア:最大50mm
試料サイズ:最大6インチデータご提供用のエクセルファイルはこちらHK-605_Laser_direct_lithography_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1375
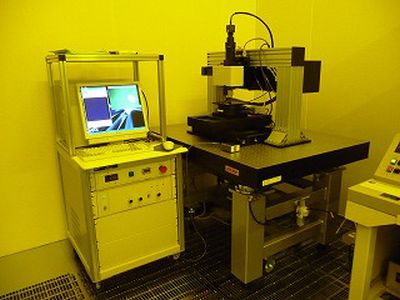
光露光(マスクアライナ)
両面マスクアライナ Double-side alignment Mask aligner
- 機器ID
- ARIM装置番号:HK-702 GFC装置番号:AP-200020
- メーカー名(英語表記)
- ズースマイクロテック(SUSS)
- 型番
- MA-6
- 装置の特長及び仕様
両面、露光精度0.6ミクロン
試料サイズ:最大6インチ
基板サイズ:不定形小片~150mm角データご提供用のエクセルファイルはこちらHK-702_Double-side_alignment_mask_aligner_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1390
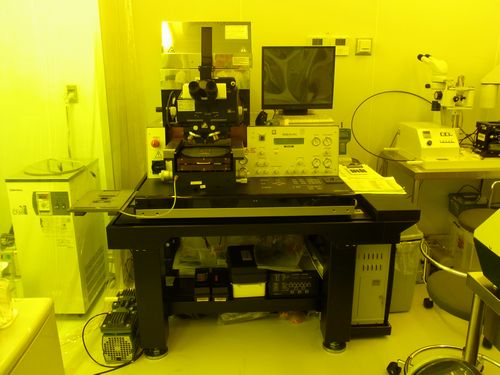
マスクアライナ Mask aligner
- 機器ID
- ARIM装置番号:HK-606 GFC装置番号:AP-200003
- メーカー名(英語表記)
- ミカサ(MIKASA)
- 型番
- MA-20
- 装置の特長及び仕様
コンタクト露光
試料サイズ:最大4インチ
マスクサイズ:最大5インチデータご提供用のエクセルファイルはこちらHK-606_Mask_aligner_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1374
