共用装置
分野から探す
真空蒸着装置 Vacuume evaporation system
- 機器ID
- ARIM装置番号:HK-608 GFC装置番号:AP-200005
- メーカー名(英語表記)
- サンバック(SANVAC)
- 型番
- ED-1500R
- 装置の特長及び仕様
蒸着源:抵抗加熱3元、EB3元
基板加熱可
水晶振動式膜厚計データご提供用のエクセルファイルはこちらHK-608_Vacuum_evaporation_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1376
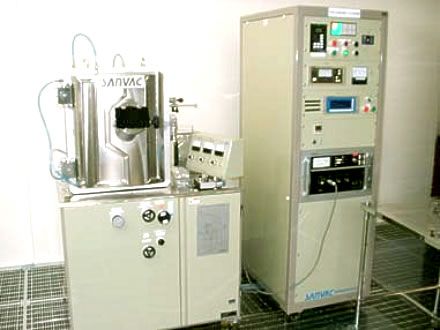
液体ソースプラズマCVD装置 Liquid Source CVD Systems
- 機器ID
- ARIM装置番号:HK-614 GFC装置番号:AP-200007
- メーカー名(英語表記)
- サムコ(samco)
- 型番
- PD-10C1
- 装置の特長及び仕様
成膜材料:SiO2他(原料持ち込み可)
キャリアガス:N2,He,Ar,H2
試料サイズ:最大3インチデータご提供用のエクセルファイルはこちらHK-614_Liquid_source_CVD_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1378

プラズマCVD装置 Plasma Enhanced CVD system
- 機器ID
- ARIM装置番号:HK-613 GFC装置番号:AP-200006
- メーカー名(英語表記)
- サムコ(samco)
- 型番
- PD-220ESN
- 装置の特長及び仕様
成膜材料:SiO2、SiN
試料サイズ:最大8インチデータご提供用のエクセルファイルはこちらHK-613_Plasma_enhanced_CVD_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1377

ヘリコンスパッタリング装置 Helicon sputtering system
- 機器ID
- ARIM装置番号:HK-609 GFC装置番号:AP-200008
- メーカー名(英語表記)
- アルバック(Ulvac)
- 型番
- MPS-4000C1/HC1
- 装置の特長及び仕様
カソード:3元(マグネトロン4インチ、ヘリコンDC2インチ、ヘリコンRF2インチ)
成膜材料:Au,Cr,Ti
試料サイズ:最大4インチデータご提供用のエクセルファイルはこちらHK-609_Helicon_sputtering_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1379

多元スパッタ装置 Multi-target Sputtering sysutem
- 機器ID
- ARIM装置番号:HK-611 GFC装置番号:AP-200072
- メーカー名(英語表記)
- アルバック(Ulvac)
- 型番
- QAM-4-STS
- 装置の特長及び仕様
カソード7元(ヘリコン2台含む)
試料:小片~最大Φ100㎜
垂直成膜可能(25mm角まで)
コスパッタ(DC/RF)、逆スパッタ
ターゲット:Au、Cr、Pt、Ag他
700度加熱可能
ラジカルイオンガン搭載(N,O)データご提供用のエクセルファイルはこちらHK-611_Multi_target_sputtering_system_PDL
装置のお問い合わせ・ご予約は GFC総合システムより承っております。
https://www.gfc.hokudai.ac.jp/system/openfacility/item/show/apparatus_list/1448
